在SMT貼片加工過(guò)程中,焊接質(zhì)量直接關(guān)系到電子產(chǎn)品的性能和可靠性。本文將針對(duì)SMT貼片加工中常見(jiàn)的焊接缺陷進(jìn)行系統(tǒng)分析,并提供實(shí)用的解決方案,幫助您提升生產(chǎn)質(zhì)量。
橋接:引腳間的短路隱患
橋接是SMT加工中尤為常見(jiàn)的缺陷,表現(xiàn)為相鄰引腳或焊盤(pán)之間被多余的焊料連接,導(dǎo)致電氣短路。
產(chǎn)生原因分析:
- 焊膏過(guò)量:模板厚度不當(dāng)或開(kāi)孔尺寸過(guò)大,導(dǎo)致焊膏沉積過(guò)多
- 印刷錯(cuò)位:高密度組件印刷時(shí)定位不準(zhǔn),使焊膏印到焊盤(pán)之外
- 焊膏塌陷:焊膏粘度不足、模板孔壁粗糙或刮刀壓力過(guò)大,造成印刷后焊膏坍塌
- 貼裝壓力不當(dāng):元件貼裝時(shí)壓力過(guò)大,使焊膏變形塌邊
解決方案:
- 根據(jù)元件引腳間距選擇合適的模板厚度,通常采用0.15mm厚度模板
- 對(duì)于引腳間距小于0.65mm的印制板,采用光學(xué)定位技術(shù)
- 選擇粘度較高的焊膏,提高保形性
- 采用激光切割模板,確保孔壁光滑
- 優(yōu)化貼裝壓力參數(shù),避免壓力過(guò)大

立碑現(xiàn)象:小尺寸元件的挑戰(zhàn)
立碑現(xiàn)象(又稱"曼哈頓現(xiàn)象")是CHIP元件回流焊接中特有的缺陷,表現(xiàn)為元件一端翹起,如同墓碑。
產(chǎn)生原因分析:
- 預(yù)熱不當(dāng):預(yù)熱溫度過(guò)低或時(shí)間過(guò)短,使元件兩端焊膏不同時(shí)熔化
- 焊盤(pán)設(shè)計(jì)不對(duì)稱:焊盤(pán)尺寸或形狀不一致,導(dǎo)致表面張力不平衡
- 貼裝偏移:元件貼裝位置偏差過(guò)大,超出焊膏熔融時(shí)的自校正能力
- 元件重量過(guò)輕:小尺寸元件更易被不平衡的張力拉動(dòng)
解決方案:
- 優(yōu)化預(yù)熱工藝參數(shù),預(yù)熱溫度一般設(shè)置在150±10℃,時(shí)間60-90秒
- 保持焊盤(pán)設(shè)計(jì)的對(duì)稱性,形狀與尺寸完全一致
- 提高貼裝精度,避免過(guò)大偏差
- 在滿足產(chǎn)品需求前提下,優(yōu)先選擇尺寸重量較大的元件
- 減小焊膏厚度,使用0.15mm以下模板
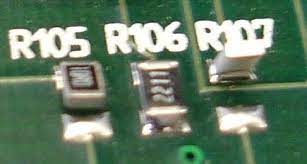
冷焊:強(qiáng)度不足的隱患
冷焊表現(xiàn)為焊點(diǎn)表面暗淡、凹凸不平,呈顆粒狀,嚴(yán)重影響焊接強(qiáng)度。
產(chǎn)生原因分析:
- 加熱不足:回流焊溫度不足或時(shí)間過(guò)短,焊料未完全熔化
- 熱容量不均:大尺寸焊盤(pán)或接地層設(shè)計(jì)不合理,導(dǎo)致熱量散失過(guò)快
- 傳送帶振動(dòng):回流焊過(guò)程中機(jī)械振動(dòng)影響焊料正常熔融
解決方案:
- 確保回流焊機(jī)具有精確的溫度控制,根據(jù)焊膏和元件要求設(shè)定適當(dāng)參數(shù)
- 優(yōu)化PCB設(shè)計(jì),對(duì)于連接到大面積銅箔的焊盤(pán),采取熱隔離設(shè)計(jì)
- 檢查回流爐傳送系統(tǒng),減少機(jī)械振動(dòng)
- 設(shè)置適當(dāng)?shù)幕亓骱附訙囟惹€,確保焊料完全熔化
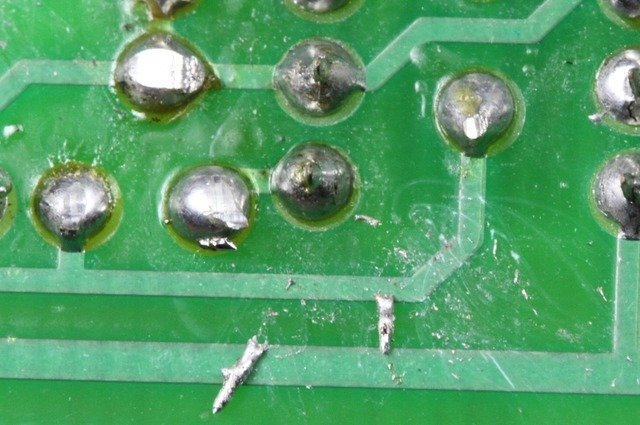
焊錫球:潛在的短路風(fēng)險(xiǎn)
焊錫球表現(xiàn)為PCB非焊接區(qū)域出現(xiàn)分散的焊料小球,可能引起電路短路。
產(chǎn)生原因分析:
- 焊膏氧化:焊膏暴露空氣中時(shí)間過(guò)長(zhǎng),氧化物含量增加
- 加熱速率過(guò)快:快速升溫使焊膏中溶劑劇烈揮發(fā),濺出焊料顆粒
- 焊膏吸濕:從冰箱取出后未充分回溫,水分凝結(jié)
- 模板開(kāi)孔不當(dāng):開(kāi)孔尺寸與焊盤(pán)不匹配
- 助焊劑活性不足:特別是免洗焊膏活性相對(duì)較低
解決方案:
- 控制焊膏氧化物含量,一般不超過(guò)0.15%
- 調(diào)整回流曲線,使焊膏在焊接前充分預(yù)熱
- 焊膏從冰箱取出后,應(yīng)在室溫下回溫再開(kāi)蓋使用
- 模板開(kāi)孔尺寸比相對(duì)應(yīng)焊盤(pán)小10%
- 加強(qiáng)印制板清洗,確保印錯(cuò)后徹底清洗
虛焊與潤(rùn)濕不良:連接不可靠的根源
虛焊表現(xiàn)為焊盤(pán)未完全潤(rùn)濕,元件與電路板之間未能形成牢固連接。
產(chǎn)生原因分析:
- 表面污染:焊盤(pán)或元件引腳存在氧化或污染
- 助焊劑活性不足:未能有效去除金屬表面氧化物
- 加熱不足:焊盤(pán)和引腳未均勻加熱到適當(dāng)溫度
解決方案:
- 確保焊接前PCB板和元件清潔,無(wú)氧化和污染
- 選擇活性適當(dāng)?shù)闹竸?/li>
- 保證足夠的預(yù)熱時(shí)間和溫度,使焊盤(pán)和引腳均勻受熱
針孔與氣孔:隱藏的內(nèi)部缺陷
針孔與氣孔是焊點(diǎn)內(nèi)部的氣體殘留造成的空隙,影響焊接的機(jī)械強(qiáng)度和導(dǎo)電性能。
產(chǎn)生原因分析:
- PCB吸濕:板內(nèi)水分受熱變成蒸汽,在焊料凝固前未完全逸出
- 鍍銅厚度不足:通孔鍍銅層過(guò)薄,不能阻止水分滲透
- 焊膏殘留氣體:助焊劑未充分蒸發(fā),殘留氣體形成空洞
解決方案:
- 焊接前對(duì)PCB板進(jìn)行預(yù)烘烤,去除水分
- 確保通孔處有至少25μm的最小鍍銅厚度
- 正確設(shè)定回流焊溫度曲線,使助焊劑充分蒸發(fā)
焊盤(pán)剝離:PCB的致命損傷
焊盤(pán)剝離是焊接時(shí)間過(guò)長(zhǎng)或反復(fù)焊接導(dǎo)致焊盤(pán)從PCB上脫離,造成永久性損壞。
產(chǎn)生原因分析:
- 過(guò)熱焊接:焊接時(shí)間過(guò)長(zhǎng)或溫度過(guò)高
- 機(jī)械應(yīng)力過(guò)大:焊盤(pán)位置受到不當(dāng)外力
- 反復(fù)焊接:同一焊點(diǎn)多次返修
解決方案:
- 控制焊接時(shí)間和溫度,避免過(guò)熱
- 維修時(shí)使用適當(dāng)?shù)墓ぞ吆图夹g(shù)
- 對(duì)于已剝離的焊盤(pán),可采用飛線或搭橋方式修復(fù)
SMT焊接缺陷的系統(tǒng)化預(yù)防策略
要有效減少SMT焊接缺陷,需要建立系統(tǒng)化的預(yù)防策略:
優(yōu)化工藝參數(shù):
- 根據(jù)不同的產(chǎn)品特點(diǎn)和元器件,精心設(shè)置回流焊溫度曲線
- 控制貼裝精度和壓力參數(shù)
- 優(yōu)化印刷參數(shù),包括刮刀角度、壓力和速度
加強(qiáng)物料管理:
- 嚴(yán)格管理焊膏的存儲(chǔ)和使用,確保在有效期內(nèi)使用
- 控制車(chē)間環(huán)境溫濕度
- 確認(rèn)元器件和PCB的可焊性
完善質(zhì)量控制:
- 實(shí)施SPC統(tǒng)計(jì)過(guò)程控制,及時(shí)發(fā)現(xiàn)工藝偏差
- 建立完善的質(zhì)量追溯系統(tǒng)
- 采用AOI、X-Ray等檢測(cè)設(shè)備監(jiān)控焊點(diǎn)質(zhì)量
結(jié)語(yǔ)
SMT貼片加工中的焊接缺陷是由多種因素共同影響的結(jié)果。通過(guò)深入了解各種缺陷的產(chǎn)生機(jī)理,采取針對(duì)性的預(yù)防措施,建立系統(tǒng)化的工藝控制體系,可以顯著提高焊接質(zhì)量和產(chǎn)品良率。 作為專業(yè)的SMT貼片加工廠,1943科技擁有完善的質(zhì)量管理體系和豐富的工藝經(jīng)驗(yàn),能夠?yàn)榭蛻籼峁└哔|(zhì)量的PCBA加工服務(wù)。我們持續(xù)優(yōu)化生產(chǎn)工藝,致力于為客戶提供"零缺陷"的產(chǎn)品體驗(yàn)。








 2024-04-26
2024-04-26